
全国服务咨询热线:
15975429334

15975429334
在材料科学与失效分析领域,准确获取材料的元素构成是破解诸多技术难题的关键步骤。材料成分分析的利器:X射线能谱(EDS)技术原理解析,正是为了帮助研发与工艺人员深入理解这一核心技术。
william威廉中文官网依托其构建的覆盖半导体全产业链的前沿检测分析体系,利用场发射扫描电镜(FESEM)配合高精度EDS探测器,可实现从硼(B)到铀(U)的元素范围分析,具备微区点分析、线扫描和面分布等多种分析模式。无论是半导体材料中的异常颗粒,还是金属合金的析出相,我们的技术专家都能通过EDS技术精准捕捉元素信息,为工艺优化与失效归因提供确凿的数据支撑。
在半导体制造领域,材料表面纳米级的化学污染、氧化及元素偏析问题,已成为影响器件电性能、可靠性和工艺稳定性的关键瓶颈。
主要应用包括:
·通过元素含量/价态对比封装基板表面工艺处理效果
·通过元素含量/价态对比器件是否受到污染
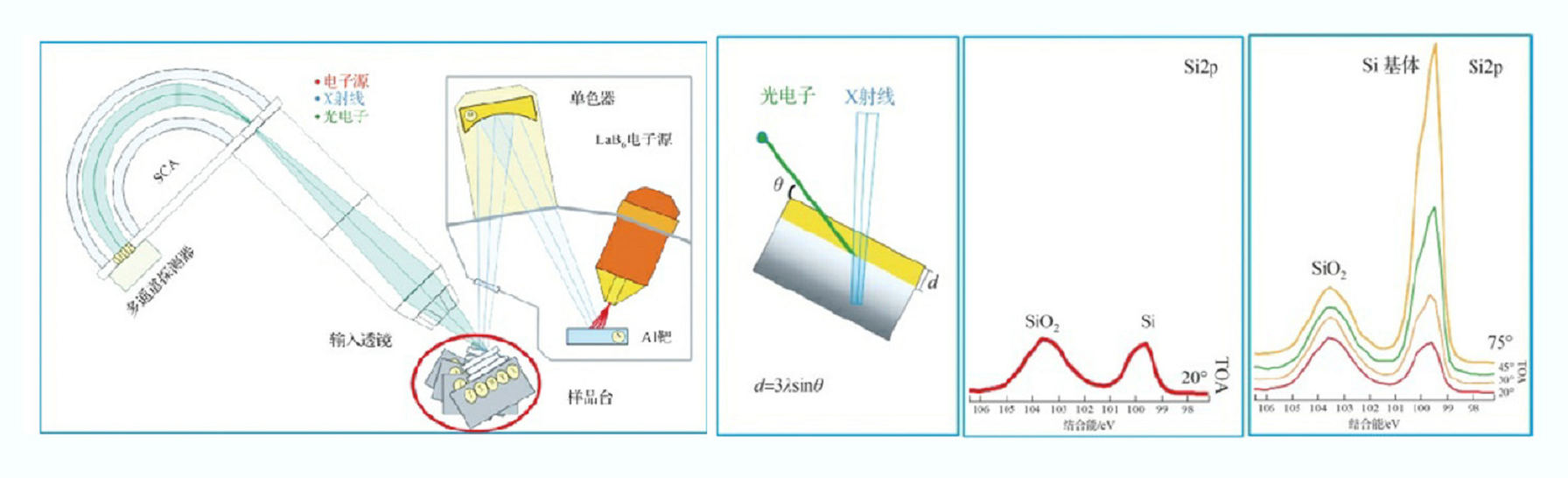
封装基板通过不同plasma处理方式后表面元素对比

正常线缆与失效线缆元素对比

 扫一扫,关注微信
扫一扫,关注微信 william威廉中文官网官方商城
william威廉中文官网官方商城电话
微信扫一扫
